
电话:13526590898
 扫一扫联系我们
扫一扫联系我们
 扫一扫看手机版
扫一扫看手机版

金刚石复合材料热沉
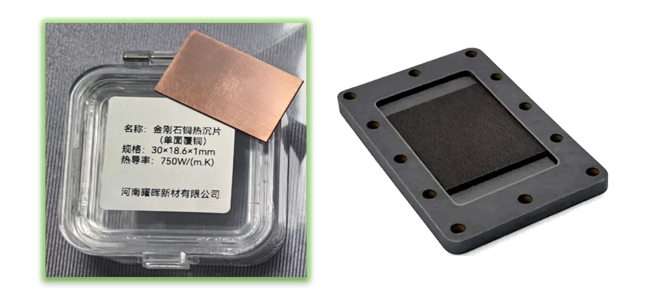
产品简介:
金刚石铜、金刚石铝、金刚石钼、金刚石碳化硅热沉片均为金刚石颗粒增强复合材料,该系列热沉片作为高功率器件的核心散热载体,具备高热导率、低热膨胀系数、高机械强度、优异热稳定性及良好封装适配性,可快速导出器件工作产生的集中热量,显著降低芯片结温,提升器件功率密度与长期可靠性。
材料体系兼具结构支撑、应力缓冲、热膨胀匹配功能,能够有效缓解芯片与封装壳体之间的热失配问题,减少热循环疲劳与界面失效风险。同时具备耐高温、耐腐蚀、低介电损耗、可金属化、可键合等特点,可满足半导体器件、射频模块、激光器件及航空航天装备在严苛工况下的散热与结构支撑需求。
金刚石复合材料壳体
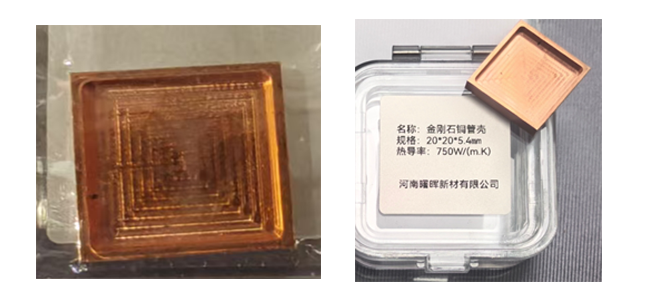
产品简介:
金刚石铜、金刚石铝、金刚石钼、金刚石碳化硅壳体具备以下功能:
结构承载与机械防护:作为器件外部壳体,提供足够刚度与强度,实现芯片、组件的封装固定,抵御外力冲击、振动与磨损,保护内部元器件完整。
高效散热与热管理:兼具壳体与热沉双重功能,快速导出器件工作热量,降低内部温升与热点集中,提升功率密度与工作稳定性。
热膨胀匹配与应力缓冲:热膨胀系数与内部芯片、基板材料相适配,减少温度循环带来的热应力,避免开裂、分层、焊料疲劳失效。
环境密封与可靠性防护:形成封闭腔体,实现防尘、防潮、防腐蚀,部分材料可耐高温、抗辐照,满足航天、车载、军工等严苛环境。
电磁兼容与电气适配:导电型壳体(金刚石铜、铝、钼铜)可实现电磁屏蔽;绝缘型壳体(SiC、金刚石‑ SiC)可实现高压绝缘隔离,兼顾电气安全。
封装工艺兼容:可进行金属化、焊接、键合、烧结等加工,与半导体、光电子、射频模块的封装流程高度适配。
尺寸稳定与长期可靠性:高温下不变形、无相变、性能衰减小,保证器件在长期工作与复杂工况下的精度与寿命。例1