
 扫一扫联系我们
扫一扫联系我们
 扫一扫看手机版
扫一扫看手机版

2026年开年,AI算力领域的热管理技术迎来里程碑式的密集突破。年初,NVIDIA正式发布下一代AI计算平台Rubin架构,并官宣在其高端芯片产品中引入CVD金刚石片。仅两个月后,行业再迎商业化落地重磅进展,Akash Systems公司宣布携手NxtGen AI Pvt Ltd交付全球首批搭载Diamond Cooling®技术的英伟达H200 GPU服务器,搭载AMD Instinct™ MI350X GPU并由MiTAC Computing (3706.TW)制造的AI服务器。

这一动作并非传统散热方案的常规迭代,而是AI算力发展到超高功耗密度阶段,从芯片架构设计向底层材料体系延伸的标志性突破——当AI芯片单芯片功耗突破1000W、核心极热点热流密度迈入约为1000W/cm²量级,传统铜基、铝基散热方案已触及物理天花板,金刚石凭借其超高热导率特性,成为破解算力热管理困局的核心解法,更将推动从芯片级散热到数据中心能效体系的全链条重构。
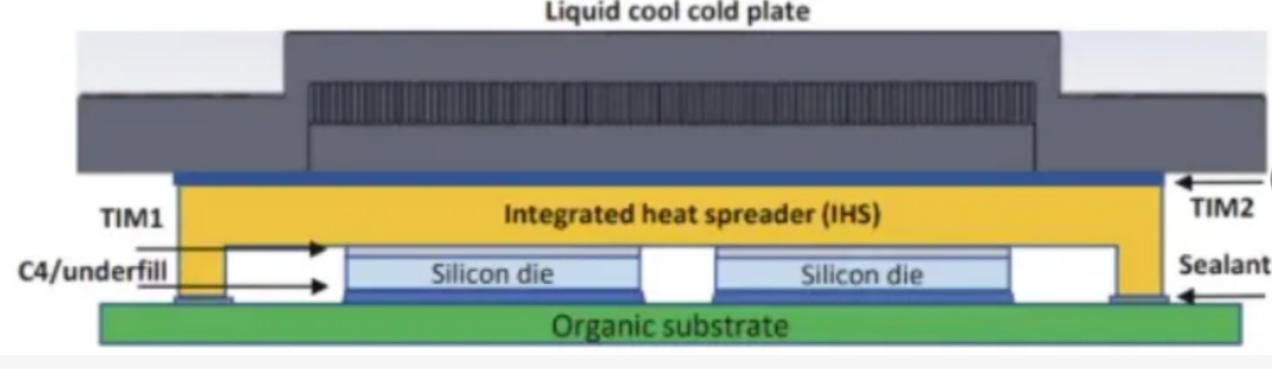
01超高密度算力时代的热管理核心困局

AI大模型的爆发式发展,推动GPU芯片向高算力密度、高集成度快速演进,热管理也从算力系统的“配套环节”,变为制约算力上限、运行可靠性与能效水平的核心瓶颈。
从芯片端来看,英伟达AI芯片单芯片功耗从H200的近1000W,升至Rubin架构高端芯片的1000-1500W,核心计算单元极热点热流密度突破1000W/cm²,远超传统工业散热方案的承载极限。传统纯铜热沉理论热导率约400W/m・K,面对超高局部热流密度时横向扩热能力严重不足,极易引发极热点温度骤升、芯片局部热应力集中,轻则导致芯片降频锁频、算力输出失稳,重则造成封装结构失效、芯片寿命大幅缩短。
从系统封装端来看,先进3D堆叠封装已成为提升算力密度的核心路径,英伟达Rubin架构延续并升级了封装技术,但也带来了严峻的“夹心热”问题——堆叠结构中,芯片层间的热流传递路径被中介层、TSV结构阻断,内部热堆积无法通过传统的芯片背面散热方案有效导出,成为超高密度3D 封装规模化落地的核心障碍。
从数据中心端来看,传统AI数据中心制冷能耗占整体PUE的三分之一,为保障芯片稳定运行,液冷系统进水温度需控制在35℃以内,高度依赖冷水机制冷,既大幅推高运营成本,也与双碳目标下的绿色算力要求相悖。芯片端散热能力不足,直接锁死了系统级散热方案的优化空间,形成【芯片热管理瓶颈→系统制冷高能耗→数据中心能效无法突破】的恶性循环。正是在这一行业共性困局下,金刚石材料凭借其极致的热物理性能,从军工、航空航天、大功率激光器等小众高端应用场景,正式走入AI算力的核心舞台,而英伟达Rubin架构的落地应用,更是金刚石散热技术从实验室走向规模化产业应用的关键节点。


02 Rubin架构金刚石散热方案的技术拆解
金刚石 / 铜复合热沉
Rubin架构高端芯片的核心散热创新,是在热沉结构中引入100–300μm厚度的CVD金刚石薄片,与铜/钨金属形成复合热沉结构,这也是当前技术成熟度最高、落地效果最明确的金刚石散热方案。
(一)极热点高效扩热:依托金刚石超高热导率,可在1000W-1500W超高功耗下,快速扩散芯片核心极热点热量,将局部热流密度降低一个数量级,解决极热点温度骤升问题。
(二)降阻减应力提可靠性:CVD金刚石片与芯片背面的界面热阻较传统铜基方案下降幅度大,梯度结构可缓解芯片与热沉的热膨胀系数失配问题,降低循环热应力,显著提升芯片长期运行的可靠性与使用寿命。
(三)保障算力稳定输出:解决高负载下芯片过热降频痛点,可保障Rubin架构芯片满负载工况下的算力持续稳定输出,避免热管理限制导致的算力损失。
3D封装 “金刚石毯” 技术
针对先进3D封装的热管理痛点,英伟达与台积电合作,在CoWoS 3D堆叠封装技术路线中,开展微米级金刚石层生长技术(“金刚石毯” 技术)的研发与验证,为下一代超高密度算力堆叠提供核心技术储备。该技术核心是在CoWoS封装的芯片中介层、堆叠芯片层间,生长微米级超薄金刚石薄膜,形成覆盖发热区域的“散热毯”。
其核心价值体现在两点:一是凭借金刚石薄膜超高的面内热导率,可快速横向扩散层间热量、均匀分散堆叠结构内部热堆积,再通过封装垂直散热路径导出,彻底破解3D堆叠芯片的“夹心热”难题;二是依托金刚石优异的电绝缘性,嵌入封装层间,不会干扰芯片信号传输与电气性能,完美适配先进封装的高密度布线要求。这一技术突破彻底打开了3D堆叠封装的算力密度天花板:当前行业主流方案受限于热管理能力,3D堆叠芯片层数通常不超过4层,而该技术成熟后,将支撑更高层数的逻辑与存储芯片堆叠,为下一代E级超算、万亿参数大模型的训练与推理提供核心底层支撑。
芯片——系统协同
英伟达的金刚石散热方案,并非孤立的芯片级技术优化,而是实现了从芯片材料到系统级能效的全链路协同。基于金刚石热沉带来的芯片散热能力跃升,Rubin架构通过金刚石散热材料,大幅提升了芯片的散热效率与热稳定性,将芯片对进水温度的容忍度提升至45℃以上,使得数据中心可完全采用自然冷源进行制冷,不仅可将数据中心电能使用率降至1.1以下,更能大幅降低制冷系统的设备投资与运营成本,实现AI算力的绿色低碳发展。

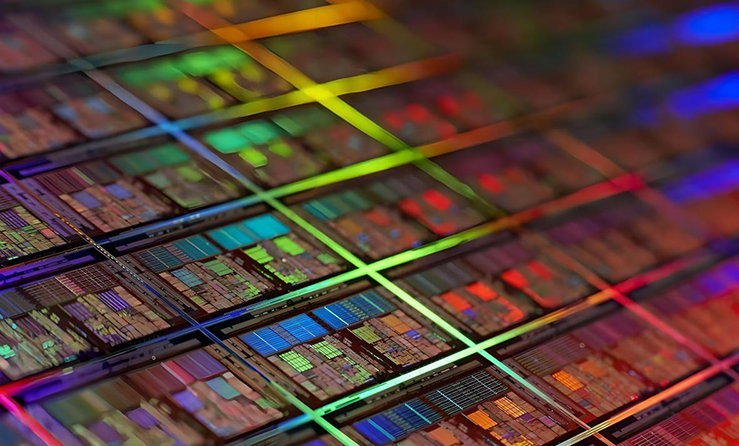
03 金刚石散热技术的产业应用发展现状

英伟达Rubin架构的落地,意味着金刚石散热技术迈入 AI 算力这一规模化应用市场,而在此之前,金刚石散热技术已完成了从材料制备到工程化应用的长期技术积累。
材料制备端,2-4英寸大尺寸CVD金刚石薄片已实现全球稳定量产,可满足半导体芯片热沉的尺寸与性能要求;海外Element Six、Coherent、Diamond Foundry,国内国机金刚石、黄河旋风、中南钻石、宁波晶钻、四方达等企业已基本实现量产突破,产品性能达到国际先进水平。此前CVD金刚石热沉已在大功率半导体激光器、相控阵雷达、航空航天电子设备等领域规模化应用,成熟的工程化经验为其进入AI芯片领域奠定了坚实基础。
应用端,此前金刚石散热技术受成本制约,仅集中在高端高附加值领域,无法在消费级、工业级半导体产品中大规模普及。而Rubin架构在高端AI芯片中的落地,将为该技术带来规模化市场需求,驱动上游材料企业扩产、优化工艺,推动材料成本快速下降,形成“需求增长→成本下降→应用场景扩大”的正向循环。
技术发展端,行业已形成清晰的三阶段迭代路线:第一阶段为当前CVD金刚石片在高端芯片背面散热的规模化落地,即Rubin架构现有应用方案、Akash Systems 已实现商业交付的Diamond Cooling®技术;第二阶段为微米级金刚石薄膜在2.5D/3D封装中的内埋散热应用,对应英伟达研发中的“金刚石毯”技术;第三阶段为单晶金刚石在芯片衬底、埋层中的集成应用,将从根本上重构半导体芯片的热管理设计逻辑
04 产业影响与未来研判

第一,热管理正式成为决定AI算力上限的核心底层技术。金刚石散热技术的落地,打破了传统散热方案的物理天花板,为单芯片2000W甚至更高功耗的设计提供了可能,将彻底释放先进制程与3D封装技术的算力潜力,推动AI算力进入全新的发展阶段。
第二,数据中心能效体系将迎来底层重构。金刚石散热技术实现了从芯片端到系统端的能效协同优化,改变了传统数据中心“制冷系统适配芯片”的设计逻辑,转向“材料定义散热系统”的全新模式。温水液冷、自然冷源的大规模应用,将大幅降低AI数据中心的制冷能耗与运营成本,同时契合全球绿色低碳的发展趋势。
第三,超硬材料行业将迎来高端化、规模化的产业升级。此前,我国金刚石产量占全球90%以上,AI算力领域的规模化应用,将为金刚石材料打开千亿级的高端应用市场,加快大尺寸高纯度CVD金刚石制备技术的国产化突破,实现超硬材料产业链的高质量发展。
第四,金刚石材料将成为第三代半导体产业的核心配套。除AI芯片外,碳化硅、氮化镓等第三代半导体功率器件、大功率激光器、射频器件等产品,均面临着严峻的热管理挑战。随着金刚石散热技术在AI芯片领域的规模化落地,成本持续下降,未来将快速渗透至整个第三代半导体产业,成为高端功率器件、射频器件的标配散热方案,形成全新的产业生态。